
(来源:新能源前沿战队)
本文数据和模型请联系:孙潇雅/张童童
摘要
产业趋势:AI服务器升级带动HVLP铜箔量利高增
AI服务器升级带动PCB性能升级(高速、低损耗)+层数增加,PCB性能主要取决于上游CCL,驱动CCL升级迭代(M7-8-9),CCL升级依赖核心原料(铜箔、电子布、树脂)升级。
用于AI服务器的铜箔主要为HVLP,在CCL成本占比3-4成。按粗糙度不同分为HVLP 1-5代,根据下游反馈,目前M8主要应用HVLP 2、3代,明年有望切4代,M9一般应用4/5代。
HVLP升级下,加工费快速提升,而成本端变化不大,故盈利弹性更大。我们预计二代加工费5-10万元/吨,三代10-15万元/吨,四代15-20万元/吨,而成本端大头是铜,其他成本波动预计在万元左右,故加工费大部分有望转化为利润弹性。三井对未来展也证明此点,其预计铜箔ROIC 24/27/30年分别在27%、39%、49%。
涨价:HVLP本环节和下游CCL公司多在海外,扩产+导入慢,旺盛需求下容易有涨价弹性
HVLP产能释放速度慢。当前AI用HVLP 铜箔多数份额在日本古河、三井,台湾金居,一则扩产意愿低,二则设备交期长(核心后处理设备依赖日本进口,目前交期在1.5年+),故产能释放速度慢。
下游CCL公司也多为日台系,对铜箔供应商验证周期长。且一般要求分阶段导入,如导HVLP前先导RTF(又有1-3代)。此格局容易带来涨价弹性,目前金居、三井已率先涨价。
产品迭代期权:DTH(载体铜箔):适用于MSAP工艺,格局更优,盈利能力更强
AI用PCB进一步升级可采用MASP工艺,此工艺适配载体铜箔。因载体铜箔较HVLP体系更轻薄,如HVLP 5代厚度一般在18微米,而载体一般在1.5-3微米。
载体铜箔格局、壁垒、利润率较HVLP上一个台阶。格局上,90%被三井垄断,利润率虽无具体数据,但从三井更重视DTH可见一斑。若后续铜箔向载体切换,需求爆发+三井专利到期趋势下,有望加速国产链导入。
投资建议:
AI铜箔是难度通胀+价格弹性赛道,通胀来自下游不断升级,对于铜箔来说,亮点在于利润弹性大于价格弹性(加工费提升>加工成本提升),此外格局上海外主导(扩产不积极)+新玩家导入周期长(设备采购、客户验证),故有价格弹性(海外已涨价)。
建议关注目前在海外供应链的稀缺标的【铜冠铜箔】、【德福科技】。
1)铜冠铜箔:HVLP1-3已向台系客户批量供货,HVLP4 铜箔测试中,我们预计最快Q4放量,载体铜箔已掌握核心技术,产业化中。
2)德福科技:拟收购的卢森堡HVLP已通过斗山供货NV,载体也已供货全球顶尖客户。德福自身HVLP1-2已经小批量供货,HVLP3已经通过日系覆铜板认证,预计下半年放量,HVLP5测试中。
风险提示:AI服务器发展不及预期、股价波动较大风险、技术发展不如预期、高端铜箔产能释放不及预期
1.
为什么关注高端PCB铜箔?
1.1. 铜箔是PCB的关键原料,高端品包括RTF、HVLP、可剥离铜箔
高端 PCB 铜箔是指应用于高频高速电路、高密度互连(HDI)、IC 封装载板、大功率电路等高端印制电路板(PCB)的高性能铜箔材料。其核心特点是低信号损耗、高平整度、超薄 / 超厚规格、优异的导热导电性及与基板的高相容性,是制造覆铜板(CCL)和 PCB 的关键原材料,直接影响电路的信号传输效率、可靠性及功率承载能力。
高端PCB铜箔包括反转铜箔(RTF)、超低轮廓铜箔(HVLP/VLP)、极薄可剥离 / 超薄铜箔。
-RTF:通过特殊表面处理降低粗糙度,提升与基板的结合力,常用于高阶 HDI 和封装载板,技术代次已从 RTF 1 代发展至 5 代。
-HVLP:表面粗糙度≤0.6μm,可减少高频信号传输中的趋肤效应损耗,适用于 5G 通信、AI 服务器、高速数据中心等场景(如英伟达新一代 AI 芯片配套的 HVLP 5 代铜箔)。
-极薄可剥离 / 超薄铜箔:厚度范围:3-12μm(如德福科技 3μm 带载体可剥离铜箔),主要用于 IC 封装载板和挠性电路板(FPC),需解决超薄状态下的强度、均匀性及剥离可靠性问题,全球市场此前被日本三井等垄断。

1.2. AI发展促进高端PCB铜箔需求和产品迭代,国产商有望分享产业增长蛋糕
AI发展刺激高端PCB铜箔需求,国产企业有望受益。随着AI技术进步,消费电子及服务器需求的增长,PCB铜箔的需求有望持续提升,高端PCB铜箔更加紧俏。
-AI与高速计算:AI 服务器对 HVLP 铜箔需求激增(单台用量为传统服务器的 8 倍),英伟达新一代 Rubin 平台明确采用 HVLP 5 代铜箔配套 PTFE 基板,推动 价值量提升。5G 与高频通信:低损耗铜箔用于基站、天线等高频器件,满足信号高速传输需求。
-高端封装与HDI:极薄可剥离铜箔用于芯片封装载板,支撑先进封装技术(如 2.5D/3D 封装)。
国内铜箔厂商在高端PCB铜箔领域实现突破,本轮AI发展国产厂商有望受益。全球高端铜箔市场约 70% 被日企(三井、古河)和韩企(索路思)垄断,国内企业正逐步进入供应链中。
-铜冠铜箔:公司较早立项研发HVLP铜箔,攻克关键核心技术,打破海外技术封锁,有效替代进口产品,目前该产品已成功进入多家头部CCL厂商供应链,订单饱满,公司具备1-4代HVLP铜箔生产能力,目前以2代产品出货为主。
-德福科技:公司2018年起就致力于高端电子电路铜箔转型,现阶段产品从性能上完全做到进口替代,公司预计2025年高频高速PCB领域和AI应用终端涉及的公司HVLP 1-4代产品,RTF 1-3代产品出货将达千吨。此外,公司今年6月公告拟全资收购卢森堡铜箔,其主要从事电子电路铜箔中的高端IT铜箔研发、生产和销售,核心产品包括HVLP(极低轮廓铜箔)和DTH(载体铜箔),终端应用包括AI服务器等数据中心、5G基站、移动终端等,具有广阔的成长空间。
1.3. 高端PCB铜箔龙头三井报表显示HVLP、载体铜箔增长可期,盈利能力强劲
核心结论:1)HVLP:25年开始高增速,利润率25-27年大幅提升;2)三井对载体铜箔重视度更高。
铜箔产品:半导体封装基板(PKG)、高密度连接板(HDI)、HVLP、半导体材料等
未来展望:1)ROIC:预计铜箔24/27/30年分别在27%、39%、49%,我们认为这说明盈利能力有望大幅提升,验证高端铜箔升级迭代趋势。2)销量增速:HVLP 2代及以上25年增速93%,25-27年复合增速13%。3)产能规划:25-27年规划中提到增加HVLP中国台湾地区工厂产能,马来工厂开始生产。

2.
HVLP铜箔
2.1.HVLP铜箔是什么?
AI发展推动产业对信息传输速度和效率的追求,根据趋肤效应原理,在高频信号传输过程中,信号更倾向于在材料表层传播,因此对铜箔基材表面粗糙度提出了极高的要求。为此,一种专为满足高频高速需求而生的铜箔产品应运而生——HVLP(Hyper Very Low Profile,超低轮廓)铜箔。
HVLP铜箔是指通过特殊工艺处理后,表面粗糙度Rz严格控制在2μm以下,适用于电子电路领域的高频高速铜箔HVLP铜箔在电子工业中具有显著优势,主要体现在低信号损耗、高密度集成、优异的导电性、热稳定性强、良好的层间结合力。

2.2.HVLP铜箔难点?设备要求高、工艺复杂、客户认证壁垒高
铜冠铜箔表示HVLP难点主要体现在设备精密程度要求高、订货周期长、生产工艺复杂、精度要求高、客户认证门槛高、周期长。
生产HVLP铜箔的过程相较于常规标箔更为严苛精密,从源头毛箔开始便对其表面粗糙度有着极高标准。具体工艺流程涵盖了酸洗、粗化、固化、合金化、钝化及硅烷偶联化等一系列复杂步骤。其中,核心技术挑战主要包括:开发并制造低粗糙度毛箔原料、精确调控粗化和固化阶段铜瘤生长、优化合金化及钝化过程中的高温抗氧化性能,以及精准实施硅烷偶联剂涂覆技术。
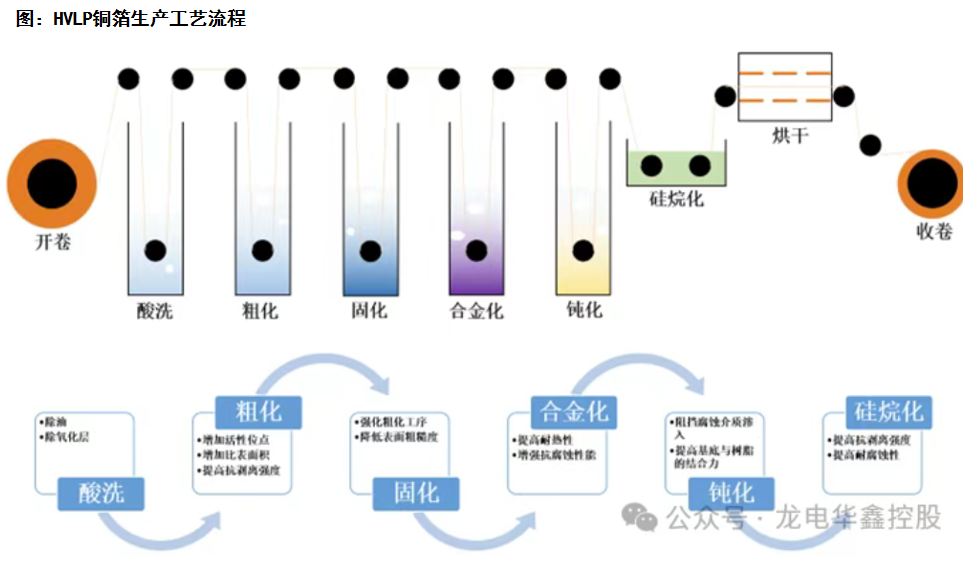
2.3.HVLP铜箔市场当前以日韩厂商为主导,国产替代空间广阔
全球范围,日韩厂商占据HVLP85%以上份额,包括三井金属(日)、福田金属(日)、古河电工(日)、斗山集团(韩)等。国内HVLP铜箔起步较晚,对外依赖度较高。
HVLP铜箔国产替代空间广阔。随着5G技术在全球范围内的深度渗透和日趋成熟,以及AI技术的快速迭代升级对高速数据中心与服务器提出的更高要求,中国企业在高频高速铜箔的研发与生产上面临着前所未有的机遇。近年来,部分企业完成高端型号技术突破,国产化进程加速,隆扬电子、铜冠铜箔、德福科技、诺德股份(维权)、逸豪新材等中国企业已完成HVLP产品的开发,并已经开始对下游客户的送样与验证,未来有望在技术创新的驱动下,逐步取代日韩等国际品牌。

3.
载体铜箔?
3.1.载体铜箔是什么?
载体铜箔(可剥离超薄铜箔)是指厚度在9 μm以下的铜箔,由载体支撑,在使用过程中可剥离。可剥离铜具有抗拉强度高、热稳定性好、剥离力稳定可控、表面轮廓低等特点,可用于生产芯片封装基板。可剥离超薄铜箔主要由载体层、剥离层、超薄铜箔层组成,载体层通常使用18或35μm电解铜箔,其中导电剥离层和超薄铜层的开发方法为重点内容。
载体铜箔主要应用于IC封装载板、高密度互连技术板、Coreless基板、IC封装制程材料、HDI领域等用途,适用于PCB制程中mSAP半加成法及Coreless制程,可大幅降低PCB及IC载板的厚度和重量,满足终端电子产品轻薄化的需求。近年来,随着高性能计算及存储芯片行业关注度提高,IC载板市场需求也显得日益旺盛。
半导体芯片技术快速发展、制程日益先进,客观上带动芯片封装领域的IC载板、类载板的细线化成为必然趋势。目前IC载板、类载板的线宽线距已细至10/10 μm—40/40 μm,传统减成法制程工艺无法制备,必须使用mSAP,需搭配可剥离型超薄载体铜箔,可大幅降低PCB及IC载板的厚度和重量,满足终端电子产品轻薄化的需求。

3.2.载体铜箔难点?工艺是生产流程的关键
载体铜箔的行业主流工艺方案是电解铜载体法,即在电解铜箔光亮面上引入剥离层,在剥离层表面使用磁控溅射或电沉积的工艺制备超薄铜箔,使基板与超薄铜箔压合以后,机械剥离除去用作载体的电解铜箔以及剥离层。
-厚度≤3 μm,以便在“闪蚀”工艺中稳定去除,避免侧蚀现象;
-表面轮廓Rz≤1.5 μm,同样是为了便于充分“闪蚀”,同时也有利于实现高频高速性能;
-剥离力稳定可控,便于使用薄铜时从剥离层上剥离,剥离力过高或过低,都将导致实际加工失败。

3.3.存储芯片为载体铜箔打开市场空间,国产化进程显著加快
近年来,随着高性能计算及存储芯片行业景气度提高,IC载板市场需求日益旺盛,为载体铜箔打开市场空间。根据Research Nester,2024年全球IC载板市场规模达到230亿美元,预计2037将达到1003亿美元。下游行业发展速度加快,带动可剥铜市场空间不断扩大。
载体铜箔属于高性能铜箔,行业技术壁垒极高,其生产技术长期被日本垄断。日本三井金属矿业株式会社(Mitsui Kinzoku)为全球最大可剥铜生产商,占市场近九成份额。在本土市场方面,随着高端IC载板市场需求增长,我国载体铜箔行业景气度进一步提升,市场国产化进程有所加快,部分公司的产品在毛面粗糙度以及铜厚等方面已到达全球先进水平。

4.
投资建议
4.1.铜冠铜箔:HVLP1-3代已批量供货,载体铜箔已掌握核心技术
公司主要从事各类高精度电子铜箔的研发、制造和销售,其PCB铜箔产品主要有高温高延伸铜箔(HTE 箔)、反转处理铜箔(RTF 箔)、高 TG 无卤板材铜箔(HTE-W 箔)和极低轮廓铜箔(HVLP 箔)等。
公司在PCB高端铜箔领域产能布局合理,产品技术领先。公司已掌握多项铜箔核心技术,特别是公司高频高速用 PCB 铜箔在内资企业中具有显著优势,其中 RTF 铜箔产销能力于内资企业中排名首位,HVLP1-3 铜箔2025H1已向客户批量供货,产量同比持续增长,HVLP4 铜箔正在下游终端客户全性能测试,载体铜箔已掌握核心技术,正在准备产品化、产业化工作。
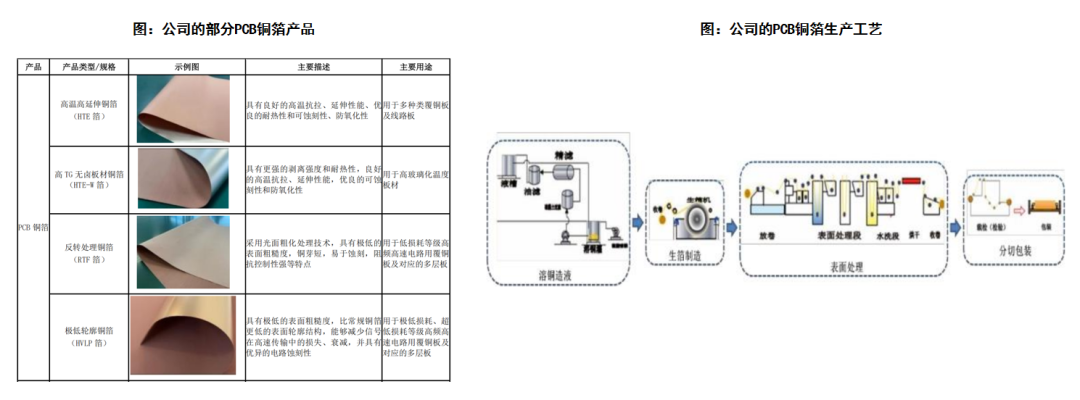
4.2.德福科技:拟收购卢森堡,进军PCB高端铜箔领域
德福科技主营业务为电解铜箔的研发、生产和销售,产品主要包括各类高性能的锂电铜箔及电子电路铜箔,产品工艺技术及制造能力行业领先。目前,公司已与宁德时代、LG化学、比亚迪、国轩高科、生益科技等客户建立了紧密的合作关系。
25年拟收购卢森堡铜箔公司,大力拓展高端PCB铜箔领域与海外市场。卢森堡铜箔是全球自主掌握高端 IT 铜箔核心技术与量产能力的唯一非日系龙头厂商,欧洲仅此一家IT电解铜箔企业,核心产品包括 HVLP(极低轮廓铜箔)和 DTH(载体铜箔),终端应用包括 AI 服务器等数据中心、5G 基站、移动终端等,具有广阔的成长空间,当前电解铜箔产能1.68万吨/年。
卢森堡铜箔具备优异的研发能力与客户资源,其研发路径围绕粗糙度、晶体结构、电信号展开,于 2017 年研发出HVLP3,2019 年研发出 1.5um 可剥离的载体铜箔,2020 年研发出HVLP4,2021年研发出 HVLP5。2024 年 HVLP3/4、载体铜箔开始批量供货全球顶尖客户,和全球头部高频覆铜板企业保持长期紧密深度合作。目前,卢森堡铜箔目前已获得全球前四家高速覆铜板企业供货资质,其中 1 家为独家供应合作,2 家为核心供应商,其余 1 家具备供货资质,对应终端客户为全球顶尖 AI 芯片厂和云厂商。
5.
风险提示
AI服务器发展不及预期:本文看AI铜箔发展和放量,若行业进展不及预期,将影响全文的逻辑推演。
股价波动较大风险:AI板块热度高,股价波动较大。
技术发展不及预期:本文对铜箔的发展有升级迭代预期,若HVLP和载体铜箔技术发展,以及下游的发展不及预期,将影响我们的判断。
高端铜箔产能释放不及预期:高端铜箔生产难度大,若实际生产不及预期,将影响我们的判断。
证券研究报告《 AI服务器发展促进高端铜箔国产替代》
对外发布时间:2025年9月9日
报告发布机构:天风证券股份有限公司(已获中国证监会许可的证券投资咨询业务资格)
本报告分析师
孙潇雅 SAC执业证书编号:S1110520080009



 海量资讯、精准解读,尽在新浪财经APP
海量资讯、精准解读,尽在新浪财经APP
优秀炒股配资门户提示:文章来自网络,不代表本站观点。



